
Präzise Schichtdickemessungen bei feinen SiO2-Masken
Das 3D-Profilometer S neox im spektroskopischen Reflektometriemodus gewährleistet die erforderliche Genauigkeit von 1 nm bei der raschen und einfachen Messung der SiO-2 Schichtdicke.
Wir untersuchen die optischen Eigenschaften von für verstärkte Emission (Purcell-Effekt) in PhC-Hohlräume (Abb. 1a), oder zur Erstellung von Photonenmultiplexern in Lichtwellenleiter (WG) (Abb. 1b) eingebetteten Quantenpunkten (QP). Ein typisches Bauelement wird aus einem mehrschichtigen, epitaktisch gewachsenen GaAs/Al0.7Ga0.3As/GaAs-Stapel hergestellt, wobei die obere 250 nm dicke GaAs-Schicht den aktiven Teil des Bauelements enthält und die 1 μm dicke Al0.7Ga0.3As-Opferschicht schließlich weggeätzt wird, um ein schwimmendes Membranbauelement zu erzeugen.
Diese Membran enthält einen oder mehrere 20 nm große In0.3Ga0.7As-QDs an bestimmten Positionen und eine geätzte PhC-Struktur (große Anordnung von 100 nm großen Löchern, wobei mehrere Löcher in einer bestimmten Konfiguration fehlen), die genau auf die QDs ausgerichtet ist. Diese Bauelemente erfordern in mehreren Arbeitsschritten eine Genauigkeit von 1-20 nm, und damit leistungsstarke Elektronenstrahllithographie. Zur Gewährleistung der Beständigkeit gegen Nass- oder Plasmaätze (ICP) zu ist eine harte SiO2 -Maske erforderlich, auf die das Lithografiemuster durch Trockenätzen (RIE) übertragen wird.
Die Genauigkeit dieser Übertragung hängt von der genauen Kenntnis der Dicke der Maskenschicht ab. Da die SiO2 -Schicht 40-80 nm dick ist, benötigen wir für diese Messung eine Genauigkeit von 1 nm. Ziel dieser Studie ist die hochpräzise (1 nm) Messungen der Dicke feiner (40-80 nm) SiO2 -Schichten, die als Hartmasken dienen.
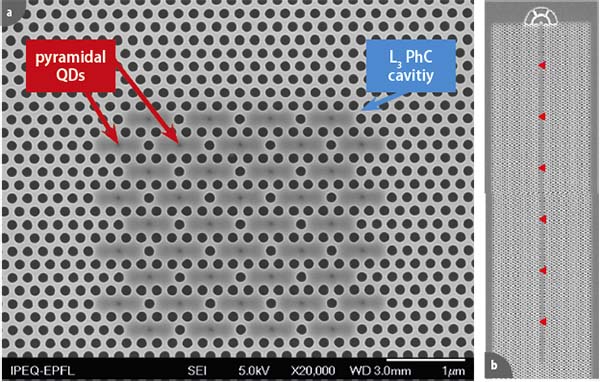
Bisher nahmen die Messung der SiO2 -Maskendicke unter Einsatz eines Tastschnittgeräts einen Tag in Anspruch und erforderten eine globale Kalibrierung mit Kalibrierungsstandards und ein spektroskopisches Sopra GES 5E Ellipsometer in einem anderen Labor. Die Profilometrie erfordert jedoch das Nassätzen einer „Stufe“ in der SiO2 -Schicht. Bei der Bearbeitung ganzer Wafer ist dieser Vorgang zu zeitaufwändig und daher nicht praktikabel. Darüber hinaus liegt das typische Rauschen bei der Profilometrie bei 5 nm RMS, so dass eine umfangreiche Mittelwertbildung erforderlich ist, um die erforderliche Genauigkeit von 1 nm zu erreichen (Abb. 2a).
Das 3D-Profilometer S neox im spektroskopischen Reflektometriemodus gewährleistet die erforderliche Genauigkeit bei der raschen und einfachen Messung der SiO-2 Schichtdicke. Unter Verwendung von einfachem GaAs als Referenz erhalten wir mit dieser Technik eine Genauigkeit von 1 nm, und das in Sekundenschnelle.

Unter Verwendung eines blanken GaAs-Substrats als Referenz wurde unter Einsatz des Einschichtmodells zunächst das Reflektivitätsspektrum von SiO2 -Schichten auf GaAs gemessen. Wie aus Abb. 2bhervorgeht, ist das resultierende Reflektivitätsspektrum sehr flach und zeigt keine für dickere (d>λ) Schichten typischen Oszillationen. Dennoch, die Anpassung des Modells ist sehr gut, die Schichtdicke (84 nm) wird mit einer Genauigkeit von 1 nm angegeben.
Die gleiche Art von Messung ist in Abb. 3zu sehen, wo eine 38 nm dicke Schicht gemessen wurde.Im Fall der GaAs-Membranstrukturen haben wir eine 3-Schicht-Struktur (SiO2/GaAs/Al0.7Ga0.3As) auf dem GaAs-Substrat. In solchen Fällen geben wir diese vollständige Struktur in das Modell ein und verwenden weiterhin GaAs als Referenz.

Im ersten Prüfschritt erfolgt die Messung des Reflexionsvermögens der nackten Halbleiter-Mehrschichtstruktur ohne SiO2. Das resultierende Spektrum (Abb. 4a) weist eine gute Anpassung auf, die im Modell die korrekten (durch Röntgenbeugung verifizierten) GaAs- und Al0.7Ga0.3As-Schichtdicken sowie eine Null-Dicke für die oberste SiO2 -Schicht ergibt. Diesmal zeigt die Reflektivitätskurve die typischen Oszillationen, die normalerweise bei dickeren (d>λ) Schichten auftreten.
Nach der Überprüfung der nackten Halbleiter erfolgte die Vermessung einer weiteren, mit SiO2 (Abb. 4b) beschichteten Probe. Die resultierende Spektrenanpassung zeigte nicht nur die Dicken der Halbleiterschichten, sondern auch die korrekte Dicke der SiO2 -Schicht (79 nm).
Als abschließende Prüfung erfolgte die Vermessung einer sowohl mit SiO2 – als auch mit PMMA-Schichten (Abb. 4c) beschichteten Probe. Dieses Mal zeigte das Spektrum komplexere Schwingungen, und die Modellanpassung war nicht so gut wie in den vorherigen Fällen. Dennoch waren die angepassten Werte korrekt, was die Leistungsfähigkeit und Schnelligkeit dieser Methode belegt.

Wir haben die mit dieser Methode erhaltenen Werte sowohl mit dem Tastschnittgerät als auch mit dem spektroskopischen Ellipsometer Sopra GES 5E als Kontrolle sowie mit kommerziellen Kalibrierungsstandards (SiO2 -Schichten auf Si, von Micromasch) überprüft und festgestellt, dass das Gerät von Sensofar eine Genauigkeit von 1 nm liefert, was genau unseren Anforderungen entspricht.
Obwohl wir mit der Anpassung von mehreren Schichten sehr gute Ergebnisse erzielt haben, versuchen wir, wann immer möglich, ein Modell anzupassen, bei dem wir alle bekannten Parameter (z. B. die Dicke der Halbleiterschichten) festlegen und nur die Dicke der obersten Schicht (normalerweise SiO2) variieren können.
Für die Herstellung komplexer photonischer Nanostrukturen benötigen wir hochpräzise (1 nm) und schnelle Dickenmessungen von dünnen (in der Regel < 100 nm) SiO2 -Schichten, die auf GaAs oder Mehrschicht-Halbleitern aufgebracht sind. Zu diesem Zweck ist die Reflexionsspektroskopie mit dem optischen 3D-Profilometer S neox von Sensofar das perfekte Werkzeug, das die von uns benötigte hohe Genauigkeit, hohe Messgeschwindigkeit und einfache Handhabung bietet.












