FORTSCHRITTLICHE PACKUNGSANWENDUNGEN
Heterogene Integration und fortschrittliches Packaging sind revolutionäre Innovationen, die verschiedene Technologien in einem einzigen, kompakten System vereinen. Dies steigert die Leistung, reduziert den Stromverbrauch und ermöglicht Anwendungen mit großer Datenkapazität wie KI, 5G und High-Performance Computing. Sie sind die Grundlage für die Zukunft – die Weiterentwicklung des Computings, da traditionelle Methoden an ihre Grenzen stoßen.
Was ist heterogene Integration?
Heterogene Integration (HI) ist eine Schlüsseltechnologie, die sich aus der Komplementarität der beiden wichtigsten Innovationsparadigmen in der Halbleiterindustrie „More Moore“ und „More than Moore“ ergibt.
„More Moore“ konzentriert sich auf die Verbesserung der Chipleistung durch Verkleinerung von Transistoren. Im Gegensatz dazu erkennt „More than Moore“ an, dass es bei Innovation nicht nur darum geht, Chips kleiner zu machen, sondern auch darum, neue Funktionalitäten hinzuzufügen.
Die heterogene Integration verbindet diese beiden Ansätze. Es ermöglicht die Kombination verschiedener Arten von Chips, die jeweils auf eine bestimmte Funktion spezialisiert sind, in einem einzigen Paket, wodurch kompakte, effiziente und hochfunktionale Systeme geschaffen werden. Dies ist unerlässlich für Anwendungen wie IoT, künstliche Intelligenz, autonome Fahrzeuge und digitales Gesundheitswesen, bei denen vielseitige und maßgeschneiderte Lösungen erforderlich sind.
Heterogene Integration (HI) ist eine Schlüsseltechnologie, die sich aus der Komplementarität der beiden wichtigsten Innovationsparadigmen in der Halbleiterindustrie „More Moore“ und „More than Moore“ ergibt.
„More Moore“ konzentriert sich auf die Verbesserung der Chipleistung durch Verkleinerung von Transistoren. Im Gegensatz dazu erkennt „More than Moore“ an, dass es bei Innovation nicht nur darum geht, Chips kleiner zu machen, sondern auch darum, neue Funktionalitäten hinzuzufügen.
Die heterogene Integration verbindet diese beiden Ansätze. Es ermöglicht die Kombination verschiedener Arten von Chips, die jeweils auf eine bestimmte Funktion spezialisiert sind, in einem einzigen Paket, wodurch kompakte, effiziente und hochfunktionale Systeme geschaffen werden. Dies ist unerlässlich für Anwendungen wie IoT, künstliche Intelligenz, autonome Fahrzeuge und digitales Gesundheitswesen, bei denen vielseitige und maßgeschneiderte Lösungen erforderlich sind.
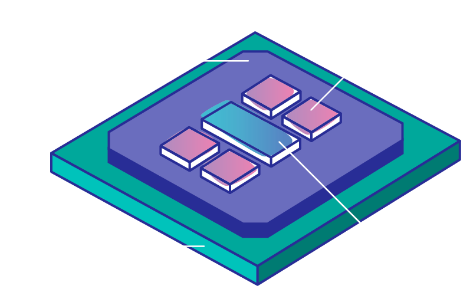
Fortschrittliche Packungslösungen variieren in Komplexität und Design und bieten einzigartige Vorteile zur Verbesserung der Leistung, Integrationsdichte und Energieeffizienz.
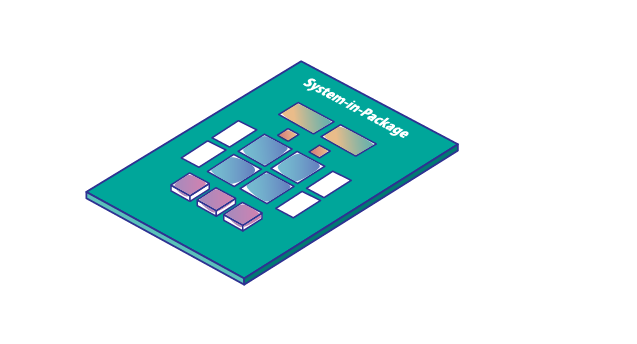
Die heterogene Integration kombiniert Materialien und Technologien, um die Leistung, Energieeffizienz und Skalierbarkeit zu verbessern, wie die jüngsten Entwicklungen bei intelligenten Packungssensoren zeigen.
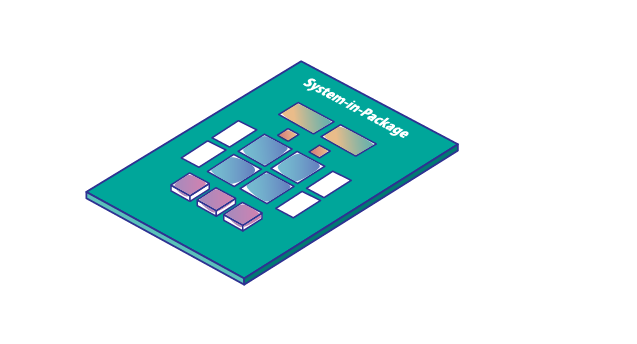
Anträge
FORTSCHRITTLICHE PACKUNG
Durch-Silizium-Durchkontaktierungen (TSVs)
Ein wichtiger Parameter zur Charakterisierung dieser fortschrittlichen Halbleiterarchitekturen ist die Tiefe der Interposer-Schicht. TSVs sind so dünn wie möglich, um Platz und Leistung in fortschrittlichen Gehäusen zu optimieren. Die Herausforderung besteht darin, durch diese kleinen, aber tiefen Löcher genau zu messen, welche interferometrisch mit dem S neox und Objektiven mit niedriger numerischer Apertur gemessen werden können. Das Hole-Plugin identifiziert und analysiert Bohrungsstrukturen innerhalb eines definierten Musters.
Ein wichtiger Parameter zur Charakterisierung dieser fortschrittlichen Halbleiterarchitekturen ist die Tiefe der Interposer-Schicht. TSVs sind so dünn wie möglich, um Platz und Leistung in fortschrittlichen Gehäusen zu optimieren. Die Herausforderung besteht darin, durch diese kleinen, aber tiefen Löcher genau zu messen, welche interferometrisch mit dem S neox und Objektiven mit niedriger numerischer Apertur gemessen werden können. Das Hole-Plugin identifiziert und analysiert Bohrungsstrukturen innerhalb eines definierten Musters.
FORTSCHRITTLICHE PACKUNG
Mikro-Bumps
Sicherstellen elektrischer und mechanischer Verbindungen in gestapelten Dies und Interposern, mit dem optischen 3D-Profilmessgerät S neox können wir die Höhe, den Durchmesser und die Koplanarität genau messen, um Verbindungsprobleme zu vermeiden und die Leistung zu verbessern. Das Bump-Plugin analysiert Bump-Strukturen einzeln oder in BGA-Formaten (Ball Grid Array).
Sicherstellen elektrischer und mechanischer Verbindungen in gestapelten Dies und Interposern, mit dem optischen 3D-Profilmessgerät S neox können wir die Höhe, den Durchmesser und die Koplanarität genau messen, um Verbindungsprobleme zu vermeiden und die Leistung zu verbessern. Das Bump-Plugin analysiert Bump-Strukturen einzeln oder in BGA-Formaten (Ball Grid Array).
FORTSCHRITTLICHE PACKUNG
Leitungsschichten (RDLs)
Für die Signalweiterleitung in fortschrittlichen Gehäusen ist es unerlässlich für den High-Tech-Fertigungssektor, die Breite, Dicke und Oberflächenqualität von Leiterbahnen zu bewerten, um die Signalintegrität zu gewährleisten. Dies ermöglicht das S neox. Das Trench-Plugin kann Gräben auf unebenen Oberflächen automatisch erkennen, um eine genaue Dimensionsanalyse zu ermöglichen.
HETEROGENE INTEGRATION
Mikrolinsen
Spielen Sie eine Schlüsselrolle bei Photonischen integrierten Schaltkreisen (PICs), die Optiken, Bildsensoren und AR-Displays im Co-Package-Bereich bereitstellen und fortschrittliche optische Funktionen ermöglichen, die über herkömmliche Komponenten und Fertigungstechniken hinausgehen. Das sphärische Plugin analysiert sphärische Oberflächen und extrahiert den Radius und die Restrauheit. Das asphärische Plugin analysiert Oberflächen anhand von Verformungskoeffizienten und Rauheitsdaten.
Spielen Sie eine Schlüsselrolle bei Photonischen integrierten Schaltkreisen (PICs), die Optiken, Bildsensoren und AR-Displays im Co-Package-Bereich bereitstellen und fortschrittliche optische Funktionen ermöglichen, die über herkömmliche Komponenten und Fertigungstechniken hinausgehen. Das sphärische Plugin analysiert sphärische Oberflächen und extrahiert den Radius und die Restrauheit. Das asphärische Plugin analysiert Oberflächen anhand von Verformungskoeffizienten und Rauheitsdaten.
HETEROGENE INTEGRATION
Co-Packaged Optik (CPO)
Integriert optischen Machinen direkt in Gehäuse, verkürzen Verbindungen und erhöhen die Bandbreitendichte und Energieeffizienz, die für datenintensive Anwendungen wie künstliche Intelligenz von entscheidender Bedeutung sind.
Integriert optischen Machinen direkt in Gehäuse, verkürzen Verbindungen und erhöhen die Bandbreitendichte und Energieeffizienz, die für datenintensive Anwendungen wie künstliche Intelligenz von entscheidender Bedeutung sind.
Diese Ansätze sind Säulen der fortschrittlichen Industrietechnik und der Schlüssel zu den Bereichen HPC, 5G, Automobil und KI. Sensofar hilft Herstellern, die Grenzen der Leistungfähigkeit zu verschieben und kleinere, schnellere und energieeffizientere Geräte zu ermöglichen.
Ausrüstung für die Halbleitermesstechnik
Moderne Fabriken benötigen schnelle, flexible und zuverlässige Messgeräte zur Inspektion von Halbleitern, und Sensofar bietet genau das.
Ihr Experte für Halbleitermesstechnik
Da die Geräte immer kleiner und leistungsfähiger werden, wächst der Bedarf an präziser und skalierbarer Messtechnik. Ganz gleich, ob Sie die Charakterisierung von Wafern in Halbleitern erforschen, nach Halbleitermessgeräten suchen oder einen vertrauenswürdigen Anbieter von Messtechnik in der Halbleiterindustrie suchen, Sensofar ist hier, um Ihnen zu helfen, immer einen Schritt voraus zu sein.
Lassen Sie uns die Zukunft der Mikroelektronik gestalten – Nanometer für Nanometer.
Ihr Experte für Halbleitermesstechnik
Da die Geräte immer kleiner und leistungsfähiger werden, wächst der Bedarf an präziser und skalierbarer Messtechnik. Ganz gleich, ob Sie die Charakterisierung von Wafern in Halbleitern erforschen, nach Halbleitermessgeräten suchen oder einen vertrauenswürdigen Anbieter von Messtechnik in der Halbleiterindustrie suchen, Sensofar ist hier, um Ihnen zu helfen, immer einen Schritt voraus zu sein.
Lassen Sie uns die Zukunft der Mikroelektronik gestalten – Nanometer für Nanometer.















